
Двуреченский А. В. (Институт физики полупроводников СО РАН)

 |
Гетероструктуры Ge/Si с квантовыми точками Двуреченский А. В. (Институт физики полупроводников СО РАН) |
 |
Введение
Определение параметров энергетического спектра, кинетики переходов между электронными состояниями, взаимодействия элементарных возбуждений, а также выявление корреляционных эффектов составляют основу проводимых в настоящее время фундаментальных исследований в области квантовых точек (КТ). Среди множества гетероструктур с КТ [1,2,3,4], изучаемых в настоящее время, структуры на основе Si всегда представляли особый интерес, связанный с перспективой интеграции проводимых разработок с базовой кремниевой технологией изготовления современных полупроводниковых приборов и схем. Существовавшие достижения в эпитаксии Ge на Si, а также перспективы использования гетероструктур Ge/Si явились естественной основой для изучения системы с КТ. С позиций фундаментальных исследований, система Ge/Si образует гетероструктуры II типа. В таких системах локализованные состояния для электронов и дырок образуются по разные стороны от гетерограницы в самосогласованных потенциальных ямах. Находящиеся в этих состояниях электроны и дырки пространственно разделены и переход между этими состояниями является непрямым в пространстве.
В настоящей работе приводятся некоторые данные по электронным свойствам массива КТ Ge, формирующегося на поверхности Si(100) за счет эффекта спонтанной морфологической трансформации упруго напряженного слоя Ge в условиях молекулярно-лучевой эпитаксии и заращенного затем слоем Si. В первых работах по исследованию таких структур нами были обнаружены эффекты кулоновской блокады и размерного квантования энергетического спектра дырок [5,6]. Нами также были найдены условия проведения низкотемпературной гетероэпитаксии, при которых удается получить островки нанометровых размеров с поверхностной плотностью (3-5)*1011 см–2 [3]. Средний размер кластеров Ge пирамидальной формы составлял 15 нм (основание пирамиды), высота пирамиды - 1,5 нм, разброс размеров не хуже 17%.
Энергетический спектр дырочных состояний
В системе Ge/Si с кластерами Ge относительное расположение энергетических зон формирует потенциальную яму лишь для дырок. Геометрия Ge островка приводит к сильному различию в энергии размерного квантования в плоскости основания пирамиды и в направлении роста (высота пирамиды много меньше размера основания). Так как симметрия задачи близка к симметрии диска, то основной энергетический уровень соответствует s-образному, а первое возбужденное - p-образному состояниям. Расчеты показали, что разница энергий между s и p состояниями определяется квантованием в плоскости основания пирамиды [7]. Таким образом, оптические переходы между данными состояниями возможны при поляризации света в плоскости основания пирамиды (при нормальном падении на структуру, что особенно важно для практических приложений).
Исследования энергетического спектра в массиве КТ Ge в Si методами электронной спектроскопии показали, что спектр дырочных состояний является дискретным. Особенность исследуемого массива КТ заключается в том, что средний размер кластеров сравним с расстоянием между ними (плотный массив). В такой системе энергия размерного квантования Eq и кулоновского взаимодействия Ec оказываются одного порядка, в отличие от часто описываемых в литературе кластеров больших размеров, в которых
Ec >> Eq [1]. В плотном массиве КТ вклад в Ec вносит как взаимодействие носителей внутри одной точки, так и взаимодействие с окружением, в отличие от случая разреженного массива, когда взаимодействием с окружением можно пренебречь. Из данных, полученных различными методами, следует, что для выбранного объекта Ge/Si с КТ Eq ~ 75 мэВ (между основным и первым возбужденным состоянием). Энергия основного состояния (от потолка валентной зоны Si) составляет 405–430 мэВ, Ec ~ 36 и 18 мэВ для основного (две дырки) и возбужденного состояний (четыре дырки), соответственно. Меньшее значение Ec для возбужденного состояния связано с большей величиной радиуса локализации дырки: 7,6 нм для основного и 15,0 нм для возбужденного состояний. При заполнении этих состояний вклад в Ec взаимодействия дырок внутри одной КТ составляет 11 мэВ для основного и 5,4 мэВ для возбужденного состояния [8,9].Энергетическая структура экситонов и экситонных комплексов
В условиях, когда плотность дырок в КТ равна нулю (КТ заполнены электронами), становятся возможными оптические переходы электронов из КТ в зону проводимости Si [9,10]. Образование экситона соответствует полосе поглощения гауссовой формы с максимумом при 770 мэВ и шириной 507–70 мэВ, обусловленной, по-видимому, флуктуациями формы и размера кластеров Ge. Энергия локализации электрона вблизи гетерограницы Ge/Si оказалась равной примерно 30 мэВ, сила осциллятора -
f = 0,5 , сечение межзонного поглощения - 2,5*10–16 см2. Эта величина более чем на порядок превосходит типичные сечения фотоионизации глубоких примесей в Si. Полученная величина f приблизительно в 20 раз меньше силы осциллятора для прямых экситонов в системе InAs/GaAS, где, что является следствием пространственного разделения электрона и дырки в системе Ge/Si (гетероструктуры II типа). Проведенный анализ в приближении самосогласованного поля с учетом неоднородных упругих деформаций показал, что при образовании экситона в системе Ge/Si с КТ электрон локализуется в окрестности вершины Ge пирамиды (в области максимальных напряжений в Si), а дырка - вблизи основания пирамиды (Рис. 1.).
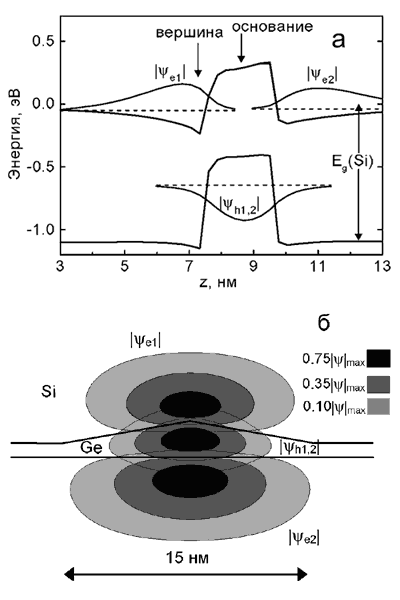
| ||
Рис. 1. (а) Расчетный профиль потенциала, в котором движутся электроны и дырки в составе экситонного
комплекса, вдоль оси z, проходящей через вершину пирамиды Ge
(б) Двумерное изображение модуля волновых функций электронов |ye| и дыркок |yh| в поперечном сечении квантовой точки и ее окружения. Степень заполнения соответствует областям, на границе которых волновые функции спадают до уровня 75%, 35% и 10% от максимального значения |
||
Основной вклад в энергию локализации электрона вблизи гетерограницы Ge/Si дает кулоновское взаимодействие электрона и дырки (28 мэВ). Вклад неоднородного распределения деформаций в формирование потенциальной ямы составляет 9 мэВ. В комплексе, состоящем из двух экситонов, отталкивание электронов приводит к их пространственному разделению, в результате которого второй электрон оказывается связанным на границе между Si и сплошным слоем Ge, на котором располагаются пирамиды.Обнаружено, что образование заряженных экситонных комплексов (две дырки - электрон), а также комплексов экситон-экситон в КТ II типа приводит к сдвигу энергии экситонного поглощения в коротковолновую область. Это синее смещение линии для заряженных комплексов связано с пространственным разделением электронов и дырок в КТ II типа, в результате кулоновское взаимодействие между двумя дырками в КТ доминирует над взаимодействием между электроном и дыркой. В биэкситоне электроны локализуются в разных местах в пространстве, и второй электрон оказывается в более мелкой потенциальной яме, чем первый. Таким образом, коротковолновый сдвиг линии биэкситона обусловлен разницей энергий размерного квантования электронов в разных потенциальных ямах.
При освещении структуры Ge/n-Si с КТ светом, вызывающим межзонные переходы, обнаружено явление отрицательной фотопроводимости. Это явление обусловлено, по-видимому, захватом электронов на состояния в потенциальной яме, формируемой на гетерогранице Ge/Si неравновесными дырками в нанокластерах Ge [11].
Межуровневые оптические переходы в КТ
В частном случае квантовой ямы с параболическим потенциалом энергия оптического перехода между подзонами не зависит ни от числа электронов в яме, ни от электрон-электронного взаимодействия, и равна энергии размерного квантования [12,13]. Для непараболического потенциала, а также при заметном вкладе кулоновского взаимодействия между КТ, энергия оптического перехода может сильно отличаться от энергии размерного квантования. Связано это с возникновением коллективных колебаний в системе под действием падающей электромагнитной волны (эффект деполяризации, наблюдавшийся в двумерных системах). С появлением КТ, в которых движение носителей заряда ограничено вовсех трех направлениях, возник вопрос о существовании коллективных эффектов при оптических переходах между уровнями размерного квантования в плоскости роста гетероструктур. В соответствии с теоретическими оценками, деполяризационный сдвиг оптического резонанса должен наблюдаться при слоевой концентрации
носителей > 1011 см–2 . В этом смысле наша система Ge/Si с плотным массивом КТ являлась идеальным объектом для выявления коллективных эффектов при межуровневых оптических переходах. При исследовании оптических переходов между уровнями в КТ в системе Ge/Si, в области энергий 70–90 мэВ наблюдается максимум поглощения, соответствующий переходу дырки из основного в возбужденное состояние [10,14]. Сила осциллятора такого перехода составила 0,95, сечение поглощения — 8*10–16 см2. Заметно меньшая величина (1,6*10–16 см2) для межуровневых дырочных переходов была получена ранее в системе InAs/GaAs с КТ. Установлено, что при малой степени заполнения Ge КТ ширина линии поглощения определяется дисперсией нанокристаллитов по размерам. Обнаружен сдвиг линии поглощения в коротковолновую область, сужение линии и изменение ее формы при увеличении концентрации дырок в основном состоянии КТ, что является характерными чертами проявления эффекта деполяризации.Приборы со встроенными слоями КТ
Исследованные к настоящему времени кремниевые полевые транзисторы со встроенным слоем Ge КТ содержали под затвором от 103 (размер подзатворной области около 1*1 мкм2) до 109 КТ [8]. Области канала транзистора и истоксток легировались бором, так что при нулевом смещении на затворе проводимость канала была высокой. При увеличении положительного потенциала на затворе происходит резкое падение проводимости (до нуля при низких температурах), обусловленное формированием области обеднения. Дальнейшее повышение напряжения приводит к появлению хорошо разрешенных пиков тока, связанных с транспортом дырок через дискретные состояния в КТ (Рис. 2.). Причем уменьшение площади области под затвором (уменьшение числа КТ) обеспечивало проявление осцилляций тока от напряжения на затворе при более высоких температурах измерений (вплоть до комнатной). Эти данные свидетельствуют о перспективности гетероструктур Ge/Si с КТ для создания одноэлектронных транзисторов.
При исследовании фотопроводимости в структурах Ge/Si со встроенными слоем КТ была продемонстрирована возможность создания фотоприемника с перестраиваемой спектральной чувствительностью. Максимальная обнаружительная способность структуры Ge/Si с КТ как фотоприемника составила 1,7*108 смГц1/2/Вт на длине волны 20 мкм и 0,7*108 смГц1/2/Вт на длине волны 10 мкм при температуре 300 К [15].
Работа выполнена при поддержке программы «Физика твердотельных наноструктур» (987–1100, 00–17–2Ф), РФФИ (99–02–39051ГФЕН, 00–02–17885).
Литература
- Jacak L., Hawrylak P., Wojs A. Quantum dots. (Berlin, Springer, 1998).
- Леденцов Н. Н., Устинов В. М., Щукин В. А., Копьев П. С., Алферов Ж. И., Бимберг Д. ФТП 32 385 (1998).
- Пчеляков О. П., Двуреченский А. В., Марков В. А., Никифоров А. И., Якимов А. И. Известия Академии наук, серия физическая. 63 228 (1999).
- Востоков Н. В., Гусев С. А., Долгов И. В., Дроздов Ю. Н., Красильник З. Ф., Лобанов Д. Н., Молдавская Л. Д., Новиков А. В., Постников В. В., Филатов Д. О. ФТП 34 8 (2000).
- Yakimov A. I., Markov V. A, Dvurechenskii A. V, Pchelyakov O. P. Phil. Mag. B 65 701 (1992).
- Yakimov A. I., Markov V. A, Dvurechenskii A. V, Pchelyakov O. P. J. Phys.: Condens. Matter., 6 2573 (1994).
- Двуреченский А. В., Ненашев А. А., Якимов А. И. Нанофотоника, материалы совещания (Нижний Новгород, ИФМ РАН, 2001).
- Двуреченский А. В., Якимов А. И. Известия Академии наук, серия физическая. 63 306 (2000).
- Двуреченский А. В., Якимов А. И. Известия Академии наук, серия физическая. 65 187 (2001).
- Якимов А. И., Двуреченский А. В., Степина Н. П., Никифоров А. И., Ненашев А. В. ЖЭТФ 119 574 (2001).
- Yakimov A. I., Dvurechenskii A. V., Nikiforov A. I., Pchelyakov O. P., Nenashev A. A. Phys. Rev. B 62 R16283 (2000).
- Wixforth A., Sundaram M., Ensslin K., English J. H., Gossard A. C. Phys. Rev. B 43 10000 (1991).
- Sundaram M. Allen S. J., Geller M. R., Hopkins P. F., Campman K. L., Gossard A. C., Appl. Phys. Lett., 65 2226 (1994).
- Yakimov A. I., Dvurechenskii A. V., Stepina N. P. Nikiforov A. I. Phys. Rev. B 62 9939 (2000).
- Yakimov A. I., Dvurechenskii A. V., Nikiforov A. I. Proskuryakov Yu. Yu. J. Appl. Phys. 89 5676 (2001).
| © 2001 — 2003 А. В. Двуреченский |